使用电子噪声和抗蚀剂模糊模型预测随机EUV缺陷密度
近年来,首次直接解决了EUV光刻中二次电子噪声的统计及其对缺陷概率的影响[1]。在本文中,我们将考虑一些更新的 EUV 抗蚀剂模糊模型,包括化学放大 (CAR) 和金属氧化物 (MOR) 类型。
首先,让我们回顾一下推导 EUV 随机缺陷概率的过程,同时考虑二次电子噪声。光子吸收的特征是经典的分裂或变薄泊松分布[2]。假设每个吸收的EUV光子释放的电子数遵循整数的均匀分布作为概率质量函数[1]。当考虑电子散射时,由此产生的有效“模糊”将嘈杂的光子吸收曲线替换为以模糊比例参数为特征的平滑曲线。
然而,这只会更新每个“像素”的平均电子数。在这里,像素代表抗蚀剂分子的尺寸,对于CAR[3,4],可以认为是2 nm x 2 nm,对于MOR[4,5],可以认为是1 nm x 1 nm。我们可以应用累积分布函数(CDF)来预测像素被预期的概率是否错误地高于或低于打印阈值。该 CDF 考虑了像素中模糊的平均电子数以及电子数噪声。为了计算给定位置出现给定尺寸缺陷的概率,我们只需计算缺陷区域内像素的此类概率的乘积[1]。这样做的一个自然结果是,较大的缺陷(包含更多像素)的概率将比较小的缺陷小得多。当我们考虑缺陷概率的音高依赖性时,这将是稍后提出的一个重要问题。
抗蚀剂模糊的意义:对比度的降低
抗蚀剂模糊本质上是抗蚀剂对光照的响应,这会导致对比度相对于初始光学图像下降。已知化学放大的抗蚀剂因酸扩散而产生模糊[4],而EUV抗蚀剂已知因EUV光子吸收释放的电子而产生模糊。
酸模糊函数一般为高斯形状[4];与模糊前图像的卷积形成模糊后图像。
电子模糊影响与卷积处理类似,但形状实际上是两个函数的差异,这允许零距离处的概率密度为零,但在合理的非零距离处允许峰值概率密度[6]。其中一个函数(“内”函数)具有较短的指数衰减长度,这有助于设置峰值概率距离,而另一个函数(“外部”函数)具有较长的指数衰减长度,它定义了长程尾部,对应于实验确定的电子衰减长度[7,8]。
降低对比度意味着所有值都更接近平均值。
电子模糊实际上包括能量从光电子能量开始下降到(接近)零的电子行进的距离。虽然电子在给定能量下的平均自由程可能约为 1 nm,但最终的电子模糊尾衰减长度很容易超过这个长度。
这两种形式的模糊都会将对比度降低到可以针对感兴趣的特定情况进行计算的程度。例如,具有标准差 s 的高斯形状与间距 p 的正弦波卷积会导致对比度降低 exp(-2*[pi*s/p]^2) 倍数,而尺度参数 b 与相同正弦波卷积的指数形状导致对比度降低 1/(1+[2*pi*b/p]^2)。当取两个指数或高斯的差值时,必须将结果除以函数相对权重的差值,以重新归一化结果。
降低对比度使所有像素电子数(或酸数)值更接近平均值。因此,随着对比度的进一步降低,CDF 计算将给出接近 50% 的像素概率。另一方面,改进的对比度意味着距离特征边缘较远的像素的概率将从 50% 进一步降低。
更新具有代表性的抗蚀剂模糊模型
深入研究文献,我们可以找到一些信息,引导我们找到 EUV 抗蚀剂的适当模糊形状。通过模拟EUV暴露引起的降解(化学变化),发现了基于PMMA的EUV抗蚀剂模型的电子模糊形状[9]。通过高斯差异(一个具有 s=3.4 nm,另一个(相对权重 79.4%),s=2.7 nm)来最好地实现与其结果的拟合。在将该电子模糊函数与光子吸收曲线卷积后,随后将 s=5nm 高斯模糊 [4] 与结果卷积,以获得代表 CAR 情况的酸曲线。对于MOR的情况,我们可以参考Bespalov等[10]中的数据,该数据显示,一个1.6 eV的电子穿透了20 nm厚的SnOH抗蚀剂,然后明显地从基板反射回来,具有剂量依赖性度,整个厚度,1.2 eV的电子也做同样的事情,但被捕获在距离抗蚀剂顶部~11-12 nm的地方, 当电子动能达到陷阱能量时。
请注意,如果电子甚至没有到达基板,则无法测量抗蚀剂厚度,因为支撑底部将被溶解。从指数拟合来看,1.2 eV 电子衰减长度为 1.4 nm,而 1.6 eV 电子衰减长度为 3.2 nm。由于所有电子必须通过 1.6 eV 才能获得捕获能量,因此外部模糊标度参数被认为是两者中较大的一个 (3.2 nm)。选择内部尺度参数(0.448 nm)和相对权重(14%)以满足以下两个条件:(1)零距离处的零概率,以及(2)1 nm处的峰值概率,与预期的分子大小相匹配[5]。图1显示了上述处理产生的电子模糊函数形状。

图 1.有机和金属氧化物抗蚀剂的代表性电子模糊函数形状。文本中提供了参数。
EUV 抗蚀剂的代表性电子噪声模型
以前[1,11],电子噪声被建模为每个光电子(即吸收光子)在5到9的整数范围内均匀分布。这允许一个电子逃逸基于Sn的MOR层。然而,对于CAR情况,我们将对Míguez等人在[9]中的结果应用相同的处理,每个吸收光子的整数范围为8到16,包括一个逃逸的电子。如[1]所示,对于范围[p,q],最小3s/avg电子噪声可以计算为3*sqrt([n^2-1]/12)/m,其中m=(p+q)/2和n=q-p+1。这为CAR情况提供了55%,对于MOR情况(如之前发表的[1])为61%。
将像素概率与 EUV 随机指标效应结合使用
像素有缺陷的概率是使用每个光子每个可能的电子数的泊松CDF平均值计算的[1]。每个光子给定电子数的泊松分布的CDF通常用伽马函数[12]来描述,基本上是exp(-N)*Nj/j!的总和(j=0到k,测试吸收的光子数),N是目标或阈值吸收的光子数。对于CAR的情况,酸量子产率(35%)乘以吸收的光子数。模糊的效果是通过缩小差异,有效地使给定像素处的吸收光子数接近平均值(在所有像素上)。缩小因子是前面提到的在吸收的光子轮廓与模糊轮廓卷积的背景下的对比度降低因子。
计算了三种情况下的像素缺陷概率:(1)ArF浸没(ArFi)40 nm半间距,80 nm厚抗蚀剂(3/um吸收),2 nm像素,s=5 nm高斯酸模糊,(2)EUV 20 nm半间距,40 nm厚CAR(5/um吸收),2 nm像素,s=5 nm高斯酸模糊,(3)EUV 20 nm半间距, 40 nm厚的MOR(20/um吸收),1 nm像素。前面介绍了EUV CAR和MOR的电子模糊形状(图1)。结果如图 2 所示。
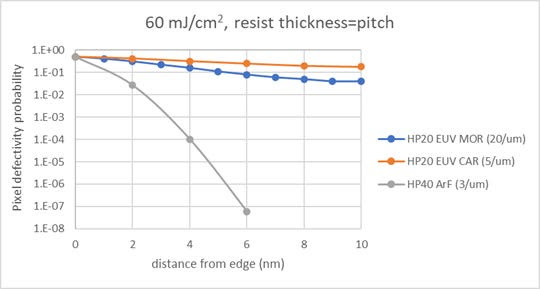
图 2.像素缺陷概率(未能达到阈值)作为距半间距线边缘距离的函数,适用于三种不同的抗蚀剂曝光情况。文中提供了抗蚀剂条件。
显然,在整个 20 nm 暴露的半间距中,EUV 曝光的缺陷比 ArFi 40 nm 半间距的缺陷呈指数级增长。这就是为什么随机缺陷只有在 EUV 光刻技术的出现后才成为一个明显的问题。
了解像素概率可以计算各种 EUV 随机效应的概率。然而,必须谨慎地形成对这些概率的解释。
边缘边界像素
首先要记住的是,边缘像素概率始终为 50%。由于它代表特征的边边界,因此我们可以在评估随机效应的实际概率时将其排除在考虑之外。
边缘粗糙度
与边缘边界像素相邻的像素线可用于评估边缘粗糙度。对于 60 mJ/cm2 的 EUV 入射剂量,CAR 和 MOR 情况每像素有 20-30 个吸收光子(分别为 5/um 和 20/um 吸收)。两种类型的抗蚀剂的电子噪声贡献也相当,与 MOR 相比,CAR 较大的平均电子/光子被更大的扩散所补偿。因此,对于两种抗蚀剂,与 20 nm 半间距边缘边界相邻的像素的像素概率为 ~30-50%。通过将该概率除以 40 nm 间距 x(2 x 像素大小)的实际平铺面积,可以找到与边界相邻的单个缺陷像素的密度。等效地,我们可以通过往复运动该密度来找到每个缺陷的面积,大致每 2 个像素出现一个边缘缺陷/30-50% = 4-6 像素(CAR 为 8-12 nm,MOR 为 4-6 nm)。这与在先前发表的图中观察到的参差不齐的边缘一致(例如,[13])。
边缘缺口/突起缺陷
像素概率从 50% 的边缘开始,并逐渐减少,从边缘向特征内部移动。因此,由于泊松噪声 + 电子噪声而形成缺陷的最有可能的位置是边缘。因此,从线边缘延伸几nm并沿线延伸几nm的边缘缺陷可以具有较高的缺陷密度,如图3所示。此处用于计算缺陷密度的平铺面积为间距 x(缺陷长度 + 1 像素)。
 图 3.三个抗蚀剂工况的边缘缺陷概率。左图:40 nm间距20 nm沟槽EUV MOR,40 nm厚度,60 mJ/cm2。中心:40 nm 间距 20 nm 沟槽 EUV CAR,40 nm 厚度,60 mJ/cm2。右图:80 nm间距ArFi CAR,目标为负极抗蚀剂中的20 nm沟槽,厚度为40 nm,30 mJ/cm2。假设 EUV 和 ArFi CAR 均存在 s=5 nm 高斯酸模糊。假设 TE ArFi 极化和 50% TE/50% TM EUV 极化。
图 3.三个抗蚀剂工况的边缘缺陷概率。左图:40 nm间距20 nm沟槽EUV MOR,40 nm厚度,60 mJ/cm2。中心:40 nm 间距 20 nm 沟槽 EUV CAR,40 nm 厚度,60 mJ/cm2。右图:80 nm间距ArFi CAR,目标为负极抗蚀剂中的20 nm沟槽,厚度为40 nm,30 mJ/cm2。假设 EUV 和 ArFi CAR 均存在 s=5 nm 高斯酸模糊。假设 TE ArFi 极化和 50% TE/50% TM EUV 极化。
显示了一个 ArF 情况以供参考,表明缺陷密度如何呈指数级降低,这要归功于在较厚的抗蚀剂中吸收了更多的光子,没有电子噪声,并且模糊对更大间距的影响要小得多。与MOR(1 nm)相比,CAR(2 nm)的像素尺寸更大也是不利的,因为与较小的MOR缺陷相比,EUV CAR缺陷的缺陷密度更差,如图3所示。
换行符
一条有缺陷的像素线穿过一条线的概率在很大程度上取决于跨越该线的像素数量。这个数字当然与线宽成正比,例如,半间距。这导致换行概率随着音高的降低呈指数级增加,如图 4 所示。这里用于计算缺陷密度的平铺面积为间距 x 2nm(即缺陷宽度 + 1 像素)。请注意,即使缺陷密度高达2e5/cm2,这也相当于524 um2/缺陷,即无法在一张SEM图片中捕获它。
 图 4.MOR 换行符的概率与音高的函数关系。这些是 1 nm 宽的抗蚀剂条未能暴露在阈值以上的情况。
图 4.MOR 换行符的概率与音高的函数关系。这些是 1 nm 宽的抗蚀剂条未能暴露在阈值以上的情况。
当间距减小到 20 nm 时,更宽的换线可能会产生较大的缺陷密度。20 nm厚的MOR中2 nm宽的换线可以具有744 / cm2的缺陷密度。在这里,平铺区域为 20 nm 间距 x 3 nm(即 2 nm 宽度 + 1 像素)。
局部模糊变化(Local Blur Variation)
模糊的局部变异可能在之前提出过[14,15]。这也会对缺陷密度产生很大影响。将外部电子模糊尺度参数从 3.2 nm 更改为 5 nm,同时保持零距离处的零概率和 1 nm 处的峰值概率,导致图 3 的 4 nm x 4 nm 边缘缺陷的密度从 200/cm2 增加到 1e5/cm2 以上!因此,晶圆上的实际缺陷密度取决于晶圆上 3.2 nm 情况与 5 nm 情况的相对概率。对于每种不同的抗蚀剂涂层,这可能不同。
光学失去了对光刻的控制
随着间距的缩小,它不再是波长或 NA,而是抵抗模糊、电子噪声和分子大小,这些已成为确定实际分辨率极限的主要因素。除了图像对比度和焦深,缺陷密度也成为新的考虑因素。这就是为什么传统的投影光刻方案在某些时候必须依赖多图案化[16]。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码



